Разработчики самых производительных решений для работы с искусственным интеллектом понимают, что упаковка играет куда большую роль, чем многие могут предположить, поэтому постоянно занимаются её усовершенствованием. А делают они это вместе с производителями микросхем, так как собственные мощности есть лишь у единиц.
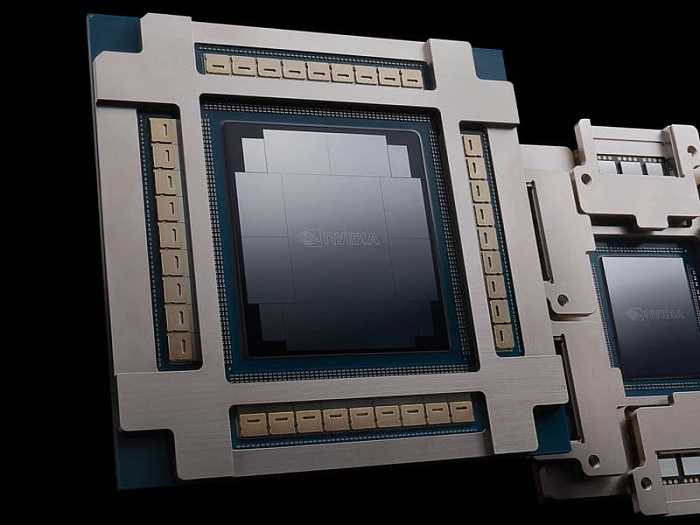
Судя по дорожной карте, опубликованной DigiTimes, компания NVIDIA может перейти на более совершенную упаковку в виде Chip-on-Wafer-on-Platform (CoWoP) относительно в скором времени. Якобы в этом месяце она начала раннее тестирование модуля с графическим процессором GB100 и фиктивными стэками HBM с применением новой упаковки, а в следующем месяце перейдёт на функциональное тестирование полноценной версии, чтобы оценить технологичность, конструктивность, электрические и тепловые характеристики, а также прочие нюансы CoWoP.
Новая технология упаковки отличается от текущего решения Chip-on-Wafer-on-Substrate (CoWoS) отсутствием подложки под микросхемой, то есть она крепится прямиком на основную плату, за счёт чего можно наблюдать уменьшение размеров конструкции, паразитных токов, помех, потребления, снижения коэффициента теплового расширения платы и повышения целостности сигнала. Также такая упаковка позволяет отказаться от теплораспределительной крышечки, снижая расходы и повышая эффективность охлаждения.
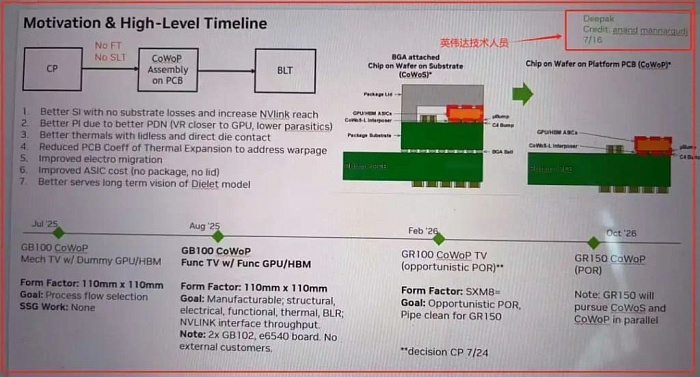
Графический процессор GB100 станет первым в модельном ряде NVIDIA, кто перейдёт на новую упаковку CoWoP, но это будет лишь своеобразная испытательная платформа для запуска GB150, где будут исправлены все ошибки и недочёты. GB100 будет выпущен в феврале следующего года, а GB150 — в октябре, причём он будет упаковываться с применением как CoWoP, так и CoWoS одновременно.
